Przełom w litografii?
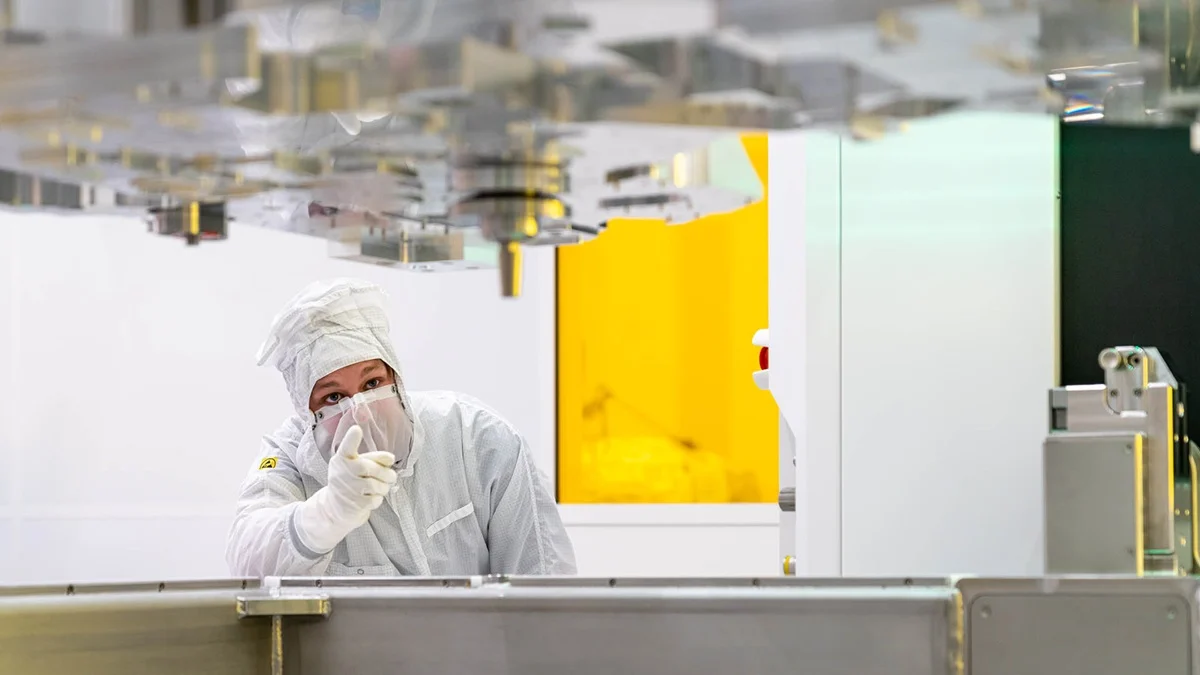
Zużycie energii przez systemy litograficzne EUV to od dawna poważny problem dla branży. Dla przykładu systemy litograficzne EUV o niskiej aperturze numerycznej (Low-NA) i wysokiej aperturze numerycznej (High-NA) zużywają odpowiednio aż 1170 kW i 1400 kW mocy.
To duże zapotrzebowanie na energię wynika z samego procesu EUV, który polega na użyciu impulsów laserowych o dużej energii do odparowania kropelek cyny (podgrzanych do około 500 000°C) dziesiątki tysięcy razy na sekundę w celu wytworzenia plazmy i emisji światła o długości fali 13,5 nanometra. Wymaga to ogromnej infrastruktury laserowej, systemów chłodzenia i środowiska próżniowego, aby zapobiec pochłanianiu światła EUV przez powietrze. Ponadto zaawansowane lustra EUV mogą odbijać tylko ułamek światła, co wymaga mocniejszych laserów w celu zwiększenia wydajności produkcji.
Według doniesień Lawrence Livermore National Laboratory (LLNL) w Stanach Zjednoczonych opracowuje laser o mocy petawatów korzystający z tulu. Mówi się, że laser ten ma potencjał zwiększenia wydajności źródeł światła litograficznego w ekstremalnym ultrafiolecie (EUV) około dziesięciokrotnie. Potencjalnie mógłby zastąpić lasery dwutlenku węgla obecnie stosowane w systemach EUV, umożliwiając szybszą produkcję chipów przy mniejszym zużyciu energii.
Projekt „Big Aperture Thulium (BAT) Laser” prowadzony przez LLNL ma na celu rozwiązanie tych problemów. W przeciwieństwie do laserów dwutlenku węgla, które mają długość fali około 10 mikronów, laser BAT działa na długości fali 2 mikronów, teoretycznie poprawiając wydajność konwersji światła plazmy na EUV podczas interakcji z kroplami cyny. Ponadto system BAT wykorzystuje technologię półprzewodnikową pompowaną diodami, która oferuje większą ogólną wydajność elektryczną i lepsze zarządzanie termiczne w porównaniu z laserami dwutlenku węgla na bazie gazu.
Początkowo zespół LLNL planuje zintegrować ten kompaktowy laser BAT o wysokiej częstotliwości powtórzeń z systemami źródeł światła EUV, aby przetestować jego interakcję z kroplami cyny przy długości fali 2 mikronów.
Brendan Reagan, fizyk laserowy LLNL, stwierdził, że w ciągu ostatnich pięciu lat zespół ukończył teoretyczne symulacje plazmy i eksperymenty dowodowe, kładąc podwaliny pod projekt. Uważa, że ten rozwój może znacząco wpłynąć na technologię EUV i jest optymistycznie nastawiony do kolejnych kroków w badaniach.
Nadal jednak istnieją poważne wyzwania w zakresie dostosowania istniejącej infrastruktury do wdrożenia lasera BAT do produkcji półprzewodników. Sama technologia EUV dojrzewała przez dziesięciolecia, a praktyczne zastosowanie BAT może również wymagać znacznego czasu.
Dane wskazują, że do 2030 r. roczne zużycie energii elektrycznej w zakładach produkujących półprzewodniki osiągnie 54 000 GW – więcej niż roczne zużycie w takich krajach jak Singapur czy Grecja. Jeśli zostaną wprowadzone systemy EUV Hyper-NA nowej generacji, zapotrzebowanie na energię może wzrosnąć jeszcze bardziej. Zapotrzebowanie branży na bardziej wydajne i energooszczędne rozwiązania EUV rośnie, a laser BAT firmy LLNL niewątpliwie oferuje obiecującą nową opcję.