Technologia High-NA EUV – Intel na czele wyścigu, ale na efekty jeszcze poczekamy
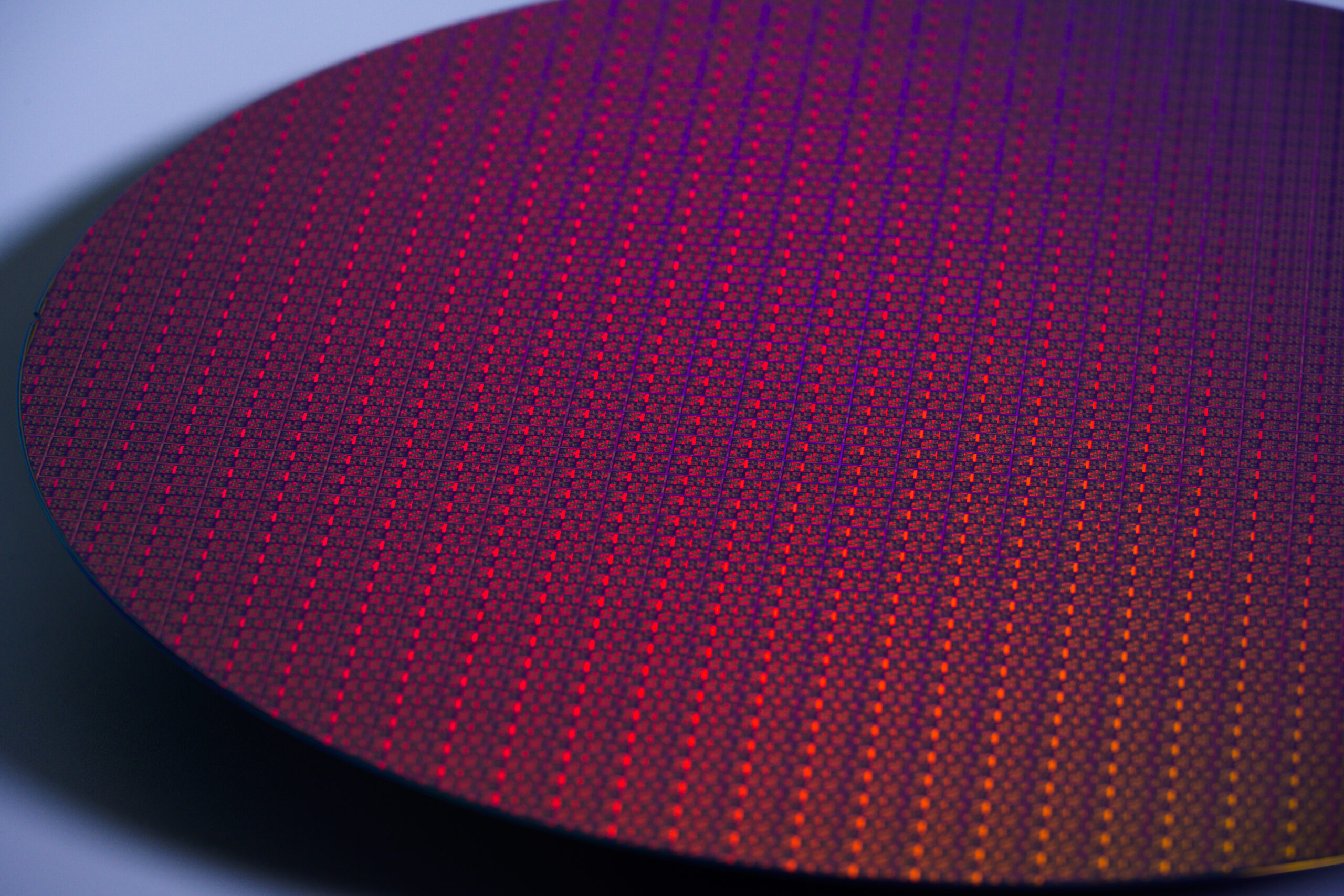
Intel okazuje się być liderem we wdrażaniu High-NA EUV, ale na szerokie zastosowanie technologii branża jeszcze poczeka. Dlaczego?
Intel wyraźnie wysuwa się na prowadzenie w wyścigu o wdrożenie litografii High-NA EUV (Extreme Ultraviolet), prezentując znaczące postępy w rozwoju tej przełomowej technologii. Firma zainstalowała już dwa skanery ASML Twinscan EXE:5000, przeprowadziła testy na ponad 30 tysiącach wafli i stworzyła własne rozwiązania w zakresie masek i korekcji optycznej. Mimo to, eksperci branżowi – w tym SemiAnalysis – zwracają uwagę, że powszechna adopcja High-NA EUV może się opóźnić z powodów ekonomicznych i logistycznych.
Koszt pojedynczego urządzenia High-NA EUV to nawet 400 mln dolarów – niemal dwa razy więcej niż w przypadku obecnych systemów Low-NA. Co więcej, koszt jednej ekspozycji High-NA jest około 2,5 razy wyższy niż w litografii Low-NA. Technologia zaczyna się opłacać dopiero wtedy, gdy zastępuje co najmniej trzy ekspozycje Low-NA – co nie zawsze jest możliwe w praktyce.
Podczas tegorocznej konferencji SPIE Advanced Lithography Intel zaprezentował konkretne dane – w tym wyniki obrazowania kluczowych warstw urządzeń – które potwierdzają techniczną gotowość High-NA EUV. Udało się m.in. uprościć proces wytwarzania warstw metalicznych, zastępując trzy ekspozycje Low-NA jedną ekspozycją High-NA i eliminując około 30 etapów procesu. W testach kontaktów, mimo zastosowania wczesnych masek testowych, udało się osiągnąć porównywalne wyniki do dojrzałych schematów multipatterningowych.

Grono dziennikarzy i pracowników Intela biorący udział w wyprawie po fabryce Intela w Arizonie. Gdzieś w tej grupie autor tego tekstu.
Intel planuje wdrożyć High-NA EUV w wybranych warstwach nadchodzącego procesu 14A (klasa 1,4 nm), który ma wejść do produkcji w 2026 roku. Firma postawiła na równoległy rozwój narzędzi, masek i oprogramowania, co pozwoliło przyspieszyć przygotowania. Efektem jest m.in. osiągnięcie 110% zakładanej mocy źródła i bardzo dobre wyniki w zakresie precyzji nakładania warstw.
Jednym z większych wyzwań High-NA EUV pozostaje ograniczony rozmiar pola ekspozycji – niemal dwukrotnie mniejszy niż w technologii Low-NA. To problem dla dużych układów, takich jak procesory i GPU, które wymagają łączenia wielu pól, co wiąże się z ryzykiem błędów i strat wydajności. Intel proponuje rozwiązanie w postaci większych masek 6×12 cali, które umożliwiłyby uzyskanie pełnego pola 26×33 mm w jednym przebiegu – jednak wymagałoby to całkowitej przebudowy łańcucha dostaw masek. ASML prowadzi badania w tym kierunku, ale nie zadeklarował jeszcze, czy taki wariant trafi na rynek.
W zakresie fotorezystów Intel wskazuje na dominację nowych formulacji tlenkowych, które lepiej radzą sobie z cienkimi warstwami i zapewniają większą odporność na trawienie. To istotne w kontekście coraz płytszej głębi ostrości związanej z optyką High-NA. Na rynku trwa też rywalizacja o przyszły standard procesu nanoszenia rezystu – pomiędzy klasyczną metodą mokrą (Tokyo Electron) a suchą alternatywą promowaną przez Lam Research.
Choć Intel deklaruje gotowość do użycia High-NA EUV już w 14A, to równocześnie podkreśla, że cały proces można zrealizować także przy użyciu tylko Low-NA EUV, choć z większym nakładem pracy. Szersze wdrożenie High-NA może zatem przesunąć się na kolejną generację technologii – klasę 1.0 nm – kiedy infrastruktura, koszty i dojrzałość procesów lepiej się zgrają. Tymczasem Intel, inwestując wcześniej i szeroko, zyskuje cenną przewagę konkurencyjną na przyszłość.






















